ВВЕДЕНИЕ
Физические свойства тонких пленок представляют интерес благодаря тому, что в этих объектах реализуются размерные эффекты, не наблюдаемые в массивных образцах. Особую роль играют тонкопленочные покрытия в оптике, где свойства создаваемых структур во многом определяются толщиной пленки . C развитием исследований в области тонких пленок актуальным становится измерение толщины нанометровых пленок. На сегодняшний день разработано множество методов, позволяющих померить толщину покрытия. Рассмотрим некоторые из них.
Контроль толщины тонких пленок
Определение толщины покрытия представляет серьезные методические трудности, в первую очередь из-за того, что понятие «толщина» применительно к тонким слоям теряет свою определенность в силу развитого рельефа поверхностей.
Существует ряд методов для измерения толщины проводящих тонких пленок: метод оптической интерферометрии, электрические, гравиметрические методы, методы с индикаторной иглой и т.д.
Разрушающие и неразрушающие методы контроля тонких пленок.
Неразрушающие
Эллипсометрия
Эллипсометрия - это быстрый, высокочувствительный и точный оптический метод определения толщин оптически в диапазоне от 400 до 2000 нм прозрачных пленок и их оптических постоянных. Метод основан на измерении изменения поляризации света при его взаимодействии с отражающей поверхностью, слоистыми структурами или при прохождении через различные среды.
Изменение фазы поляризованного света проявляется в результате прохождения света через слой (гетеро, эпитаксиальный и т. д.) и дальнейшего отражения от лицевой поверхности, что позволяет извлекать оптические свойства материалов в этой структуре
Метод эллипсометрии Суть метода поясняется рис 1. На исследуемый образец падает плоско поляризованная волна, которая после отражения становится в общем случае эллиптически поляризованной. Параметры эллипса поляризации, т.е. ориентация его осей и эксцентриситет, определяются оптическими свойствами отражающей структуры и углом падения света. В эксперименте измеряется отношение комплексных коэффициентов отражения для двух типов поляризации световой волны: в плоскости падения (p) и перпендикулярно к ней (s). Это отношение принято выражать через эллипсометрические параметры ψ и ∆, которые характеризуют относительное изменение амплитуд для p- и s-поляризаций и сдвиг фаз между ними:
 .
(1)
.
(1)
. Для определения толщины и / или оптических констант после измерения ψ и Δ строится модель, соответствующая структуре пленки.
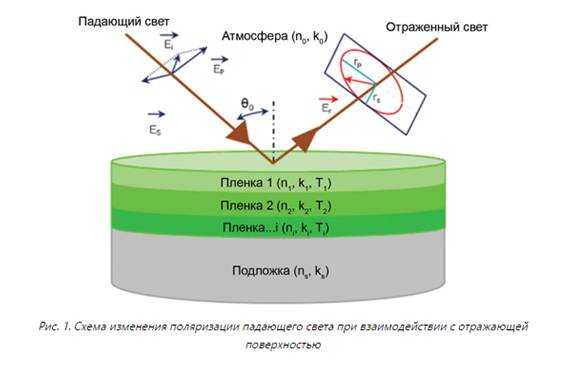
Рисунок 1 | Схема, поясняющая принцип эллипсометрических измерений.
Эллипсометрический эксперимент предполагает последовательное выполнение следующих шагов:
– проведение необходимого количества измерений (определение левой части уравнений вида (1));
– выбор адекватной оптической модели, описывающей отражающие свойства исследуемого образца (моделирование правой части уравнения (1));
– численное решение системы уравнений и определение искомых параметров модели;
– интерпретация полученных численных результатов на языке физических характеристик исследуемого объекта.
Существующие на сегодняшний день модели позволяют рассчитать коэффициенты отражения многослойных и неоднородных по толщине структур, гетерогенных слоев, состоящих из смеси нескольких компонентов, описать отражение от шероховатых поверхностей и островковых пленок. В результате такого комплексного подхода удается проводить неразрушающий оперативный контроль достаточно сложных слоистых наноструктур.
ЭЛЛИПСОМЕТРИЧЕСКАЯ АППАРАТУРА
Существует большое разнообразие оптических схем эллипсометров – приборов для измерения эллипсометрических параметров. В основе всех этих измерений лежит преобразование поляризации света оптическими линейными элементами – поляризационными призмами и фазосдвигающими устройствами. Суть измерений можно пояснить с помощью схемы на рис. 2. Монохроматический пучок света, излучаемый источником, проходит через поляризационную призму (поляризатор Р) и приобретает линейную поляризацию. После отражения от исследуемой поверхности S поляризация света становится эллиптической. Параметры этого эллипса анализируются с помощью фазосдвигающей пластинки (компенсатора С) и второй поляризационной призмы (анализатора А). При некоторых азимутальных положениях оптических элементов световой пучок полностью гасится, и фотоприемник регистрирует нулевой сигнал. Определяя экспериментально эти положения, измеряют эллипсометрические параметры. Это принцип работы нулевого эллипсометра.

Рисунок 2 | Схема эллипсометрических измерений. Р – поляризатор, S – отражающая поверхность, С – компенсатор (фазосдвигающий элемент), А – анализатор
По функциональным возможностям коммерчески доступные эллипсометры можно условно разделить на несколько классов.
Прежде всего, это спектральные эллипсометры, позволяющие проводить измерения в оптическом диапазоне от ближнего ИК вплоть до вакуумного ультрафиолета. Основная область применения таких приборов – научные исследования: измерение спектров оптических постоянных и спектральных характеристик различных материалов [11- 19], анализ неоднородных и слоистых структур [20- 22], характеризация сверхчистой поверхности [23, 24]. Как правило, работа со спектральными эллипсометрами предполагает высокую квалификацию пользователя как в области проводимых исследований, так и в части интерпретации результатов эллипсометрического эксперимента.

Рисунок 3 | Внешний вид спектрального эллипсометра: он состоит из блока осветителя и измерительного блока, соединенных оптоволокном
Другой класс аппаратуры – лазерные быстродействующие эллипсометры. Эти приборы используются не только в научных исследованиях, но и в высокотехнологичном производстве в качестве инструмента контроля [25]. Простота в эксплуатации позволяет работать на них персоналу средней квалификации. Иногда такие эллипсометры, встроенные в технологическую линейку, используются как индикаторы, сигнализирующие об отклонении технологического процесса и позволяющие отбраковывать некондиционную продукцию. Высокое быстродействие лазерных эллипсометров находит широкое применение также при исследовании кинетики быстропротекающих процессов [26, 27]. Для проведения локальных измерений на поверхности и исследования микрообъектов изготавливается аппаратура, с размером зондирующего пятна несколько микрон. В автоматическом режиме за короткое время с помощью такого прибора можно сделать картирование физических характеристик по поверхности исследуемого образца.
Лазерный эллипсометр имеет похожий внешний вид, но без блока осветителя. В качестве источника света в нем используется HeNe лазер, который смонтирован прямо на плече поляризатора. Газовый лазер дает стабильное узконаправленное монохроматическое излучение высокой мощности с высоким отношением сигнал/шум. Это, в свою очередь, обеспечивает высокую точность измерения за очень малое время.
При падении излучения на поверхность образца под очень малым углом (~10-3-10-2 рад, скользящая геометрия) происходит рассеяние, отражение, поглощение, которые свидетельствуют, как о структуре самой поверхности, так и об изменении плотности рассеяния вглубь образца (рис.1).
Меняя угол падения и анализируя только зеркально отражённый луч, получают так называемые рефлектометрические кривые (рис. 2). Анализ таких кривых позволяет установить глубинную структуру тонких плёнок, многослойных массивов, а также судить о шероховатости поверхности и интерфейсов между отдельными слоями.

И с с л е д о в а н и я м е т о д о м р е н т г е н о вс к о й р е ф л е к т о м е т р и и. Метод рентгеновской рефлектометрии основан на измерении отражательной способности рентгеновских лучей поверхностью материала вблизи угла полного внешнего отражения. При углах скольжения, меньших критического θc , происходит явление полного внешнего отражения рентгеновских лучей, при котором излучение не заходит во вторую среду и практически полностью отражается на границе раздела. Критический угол чрезвычайно мал и зависит от электронной плотности материала. Чем выше угол падающего рентгеновского пучка по отношению к критическому углу, тем глубже рентгеновские лучи проникают в материал. Для материалов, поверхность которых можно считать идеально плоской, отражательная способность резко уменьшается при углах больших критического. Если поверхность материала шероховатая, это вызывает более резкое снижение отражательной способности. Если материал с плоской поверхностью используется в качестве подложки и равномерно покрыт слоем другого материала, имеющего отличную электронную плотность, то отражения рентгеновских лучей от поверхности тонкой пленки и от границы раздела между подложкой и тонкой пленкой будут либо усиливаться, либо ослабляться, интерферируя друг с другом и образуя осцилляционный рисунок. В первом приближении, интенсивность, рассеянная образцом, пропорциональна квадрату модуля Фурье-преобразования электронной плотности. Таким образом, профиль плотности электронов можно вывести из измеренной интенсивности, а затем могут быть определены толщины слоев, их шероховатость и ряд других свойств


Схема параллельных измерений
на двух спектральных линиях с помощью полупрозрачных монохроматоров
Элементы схемы. XS - источник излучения, S - образец,
STM- полупрозрачный монохроматор,
M2 - второй монохроматор,
D1 - α-детектор, D2 - β-детектор
SS – полупроводниковый спектрометр
Электрические методы
включают измерения электросопротивления пленки Rдвух- или четырех зондовым методом и расчет толщины по соответствующим формулам с учетом удельного сопротивленияr. Для двухзондового метода
 ,
,
где l– длина пленки (расстояние между контактами);
а– ширина пленочной дорожки.
Гравиметрические методыоснованы на взвешивании подложки до и после нанесения пленки. Средняя толщина пленки дается в ангстремах формулой
 ,
,
где ∆P– разность веса, мкг;
S– площадь образца, см2 ;
r – плотность пленки, г∙см-3.
Электрические и гравиметрические методы просты, однако, требуют знания в первом случае удельного сопротивления, во втором – плотности пленки.
Методы оптической интерферометриииспользуют явление интерференции света. В данной работе использован принцип образования интерференционных полос в интерферометре Майкельсона примененного в промышленном интерферометре МИИ-4.
Прибор МИИ-4 позволяет измерять высоты неровностей в пределах от 1 до 0,03 мкм.
МЕТОДИКА И ТЕХНИКА ЭКСПЕРИМЕНТА Для измерения толщины и микрорельефа использовался модифицированный микроинтерферометр МИИ-4, принцип действия которого основан на эффекте двухлучевой интерференции в отраженном свете (рис. 1). Для измерения толщины пленки, нанесенной на плоскую полированную подложку, необходимо, чтобы часть последней была свободной от пленки, образуя четкую ступеньку. Это достигается экранированием участка подложки при нанесении пленки, стравливанием или механичес- Мешалкин А.Ю., Андриеш И.С., Абашкин В.Г., Присакар А.М., Тридух Г.М., Акимова Е.А., Енаки М.А., Электронная обработка материалов, 2012, 48(6),
2 ким удалением ее части. Наличие ступеньки в толщине пленки приводит к смещению интерференционных полос на интерферограмме (рис. 2). Толщина непрозрачной пленки определяется по формуле h = λ, 2 b c (1) где λ длина волны используемого света; с смещение ахроматической полосы на ступеньке; b расстояние между полосами. Рис. 1. Оптическая схема микроинтерферометра МИИ-4 с установленной веб-камерой. 1 опорный луч; 2 предметный луч; O линзы; D диафрагмы; M зеркала; P светоделительная пластинка; C компенсирующая пластинка; S образец; W веб-камера. Рис. 2. Смещение на величину с ахроматической полосы на интерферограмме в белом свете на ступеньке в толщине h. Модернизация микроинтерферометра МИИ-4 состояла в установке цветной цифровой вебкамеры Logitech HD Webcam C x720pxs c помощью адаптера (рис. 3). Это позволило существенно упростить процесс измерения толщины и обрабатывать изображение интерференционной картины на ПК. Для более точной оценки измеряемых толщин по сохраненным интерферограммам было разработано программное обеспечение Optic Meter, позволяющее представить интерференционную картину в аналитической форме и точно рассчитать величины b и с.
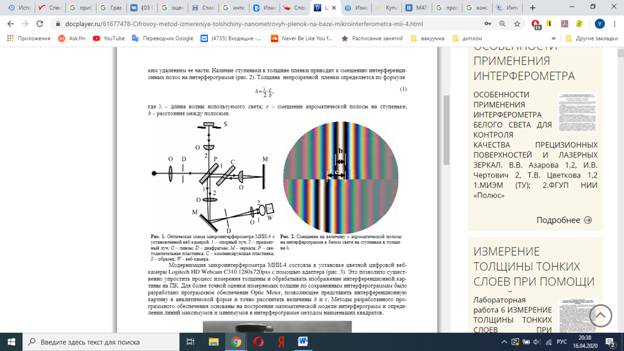
При установке на прибор плоского отражающего образца на его изображении образуются интерференционные полосы (рис. 2.53)
1 2


а) б)
Рис. 2.53. Интерференционная картинка плоской поверхности (а); б – ступенька пленки (1) – подложка (2)
Если на подложке сформировать ступеньку пленка-подложка, то интерференционная картина изменится (рис. 2.53, б).
По этой картинке пользуясь окуляром-микрометром можно определить толщину пленки
d=0,27(N3-N4)/(N1-N2) (мкм),
где N1,N2,N3,N4–отсчеты окуляра-микрометра.
Профилометрия
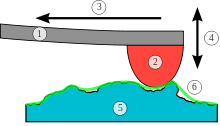
Консоль (1) держит иглу (2), которая перемещается горизонтально в направлении (3) над поверхностью объекта (5). Движение иглы повторяет основные неровности профиля и соответственно двигает консоль вертикально. Вертикальная позиция (4) записывается как измеренный профиль поверхности (6)(светло-зелёная линия).
онтактный профило́метр — прибор, предназначенный для измерения неровностей поверхности. Для оценки неровности поверхности часто используют специальный показатель — шероховатость поверхности. Типичный профилометр содержит шкалу, на которой и отсчитываются значения показателя шероховатости поверхности.
В технике профилометры в основном предназначены для измерений в лабораторных и цеховых условиях машиностроительных, приборостроительных и других предприятий, а также в полевых условиях, шероховатости поверхностей изделий, сечение которых в плоскости измерения представляет прямую линию.
D оптический профилометр













 (zip - application/zip)
(zip - application/zip)










